авдання для попередньої підготовки.
ЛАБОРАТОРНА РОБОТА №2
Тема: Дослідження біполярних транзисторів.
Мета роботи:вивчення принципу дії та властивостей, дослідження характеристик, ознайомлення з основними параметрами та використанням біполярних транзисторів.
Матеріальне забезпечення занять
1. Типове робоче місце: персональний комп’ютер.
2. Програма ELECTRONICS WORKBENCH.
Короткі теоретичні відомості
Розрізняють три схеми включення біполярних транзисторів; із спільною базою (СБ), із спільним емітером (СЕ) із спільним колектором (СК), показані на рис.5.1

Рис.5.1 Основні схеми включення транзисторів
У бібліотеку EWB включена досить велика кількість імпортних біполярних транзисторів. У деяких випадках може виявитися більш зручним самостійно створити окрему бібліотеку вітчизняних транзисторів, використовуючи команду Modelз меню Circuit
До складу параметрів транзисторів включені наступні (див. рис. 5.2, у квадратних дужках приведені позначення параметрів, прийняті в EWB 5.0).
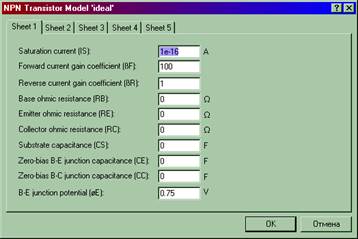
Рис.5.2 Діалогове вікно установки параметрів біполярних транзисторів.
- Зворотний струм колекторного переходу, A (Saturation current Is [IS]);
- Коефіцієнт підсилення струму в схемі з ЗЕ H21, (Forward current gain coefficient BF [BF]);
- Коефіцієнт підсилення струму в схемі з ЗЕ при інверсному включенні транзистора (емітер і колектор міняються місцями) (Reverse current gain coefficient BR [BR]);
- Об'ємний опір бази, Ом (Base ohmic resistance rb [RB]);]
- Об'ємний опір колектора, Ом (Collector ohmic resistance rc [RC]);
- Об'ємний опір емітера, Ом (Emitter ohmic resistance re [RE]);
- Ємність емітерного переходу при нульовій напрузі, Ф (Zero-bias B-E junction capacitance Се [СJE]);
- Ємність колекторного переходу при нульовій напрузі, Ф (Zero-bias С- E junction capacitance Cc [CJC]);
- Ємність колектор-підкладка, Ф (Substrate capacitance Cs [CJS]);
- Час переносу заряду через базу, з (Forward transit time t [TF]);
- Час переносу заряду через базу в інверсному включенні, з (Rеvеrs transit t[TR]);
- Коефіцієнт плавності емітерного переходу (У-E junction grading coefficient me [ME]);
- Коефіцієнт плавності колекторного переходу (З junction grading coefficient me [MC]);
- Напруга Ерлі, близьке до параметра Uк max, У (Early voltage VA [VA]);
- Зворотний струм емітерного переходу, A (Base-Emitter Leakage Saturation Current Ise[ISE]);
- Тік початку спаду посилення по струму, близьке до параметра Iк max , A (Forward Beta High-Current Knee-Point Ikf [IKF]);
- Коефіцієнт неідеальності емітерного переходу (Base-Emitter Leakage Emission Coefficient Ne [NE]).
- Контактна різниця потенціалів переходу база-колектор, У (З junction potential pc[VJC]).
- Контактна різниця потенціалів переходу база-емітер, У (В-І junction potential ре [VJE]).
Набір параметрів, що задаються, для біполярних транзисторів у EWB 5.0 помітно більше, ніж у EWB 4.1-вони зібрані в п'ятьох вікнах-закладках. Додаткові параметри знаходяться в останніх трьох закладках, одна з яких показана на мал.3. Ці параметри мають наступне призначення:
- NF-коефіцієнт неідеальності в нормальному режимі;
- NR-коефіцієнт неідеальності в інверсному режимі;
- IKR — струм, початку спаду коефіцієнта підсилення струму в інверсному режимі, А;
- NC — коефіцієнт неідеальності колекторного переходу;
- RBM — мінімальний опір бази при великих струмах. Ом;
- IRB — струм бази, при якому опір бази зменшується на 50% від різниці RB-RBM, A;
- XTF— коефіцієнт, що визначає залежність часу TF переносу зарядів через базу від напруги колектор-база;
- VTF — напруга колектор-база, при якому починає позначатися його вплив на TF, У;
- ITF — струм колектора, при якому починається позначатися його вплив на TF, А;
- PTF — додаткове фазове зрушення на граничній частоті транзистора Fгр=1/(2piТF), град.;
- VJS — контактна різниця потенціалів переходу колектор-підкладка, У;
- MJS — коефіцієнт плавності переходу колектор-підкладка;
- XCJC — коефіцієнт розщеплення ємності база-колектор;
- FC — коефіцієнт нелінійності бар'єрної ємності прямо зміщених переходів;
- EG — ширина забороненої зони, ев;
- ХТВ — температурний коефіцієнт підсилення струму в нормальному й інверсному режимах;
- XТI — температурний коефіцієнт струму насичення;
- КF — коефіцієнт фліккер-шума;
- AF- показник ступеня у формулі для фліккер-шума;
- TNOM-температура транзистора;
У програмі EWB використовується модель біполярного транзистора Гуммеля-Пуна.Розглянемо способи виміру основних характеристик біполярних транзисторів.

Рис.5.3 Додаткові параметри біполярних транзисторів.

Рис.5.4 Схема для дослідження ВАХ біполярного транзистора
Вольтамперні характеристики.Найбільш розповсюдженої і більш простою моделлю (у порівнянні з моделлю Гуммеля-Пуна) біполярного транзистора є модель Еберса-Молда. Відповідно до цієї моделі статичні вхідні і вихідні ВАХ транзистора в схемі з ПРО описуються наступними вираженнями:
Ie=A I'eo-aCI'ko; (1)
Ik=A aI'eo-CI'ko; (2)
де A=exp(Ueb/Ut)-l; C=exp(Ukb/Ut)-l; I'eo=DIeo; D=1-a*a';Ieo,Iko— теплові струми колекторного і емітерного переходів; a,a'— коефіцієнти передачі струму в схемі з ПРО для прямого й інверсного включення транзистора; Ukb, Ueb — напруга на колекторі і емітері щодо бази.
Схема для дослідження ВАХ транзистора показана на мал. 4.4. Сімейство вихідних ВАХ Ie, f (Ueb) знімається при фіксованих значеннях Ukb шляхом зміни струму Ie і виміру Ueb. Сімейство вихідних ВАХ Ik= f(Ubk) знімається при фіксованих значеннях Ie шляхом зміни напруги Ubk, і виміру Ik.
Модуль коефіциєнта передачі струму |H21э| на високій частоті може бути змінений зі схеми на мал. 4.5 . Режим по постійному струмі транзистора задається за допомогою джерела струму Ie (5 ма), як джерело вхідного синусоїдального сигналу використовується джерело струму Ii (1 ма, при вимірах частота варіюється в межах від одиниць до десятків МГц), струм бази Ib і колектора Ik виміряється амперметрами в режимі АС. Конденсатор Сb — блокувальний (так називана розв'язка по високій частоті). Модуль коефіцієнта передачі струму |H21э|=Ik/Ib розраховується за показниками амперметрів. Зокрема, при частоті вхідного сигналу 1 МГц він дорівнює, відповідно до показань амперметрів (див. мал. 4.5), 953/47,8=19,94 (у діалоговому вікні транзистора 2N2904A він установлений рівним 20).

Рис.5.5 - Схема для вимірювання коефіцієнта передачі струму на високій частоті.
На рис.4.6 наведено приклад створення моделей вітчизняних транзисторів:
Model IDEAL NPN : Ідеальній транзистор с іменем IDEAL структури п-р-п.
- .model KT361A PNP (Is=23.68f Хti=3 Еg=1.11Vaf=60 Bf°90Ne= 1.206
- + Ise=23.68f Ikf=.1224Xtb=1.5Br=4.387G Nc=1.8 Isc=900p Ikr=20m Rc= 5
- + Cjc=7p Mjc=.333Vjc=.7Fc=.5Cje=10p Mie=.333Vje= .7
- + Tr=130.5n Tf=0.1n Itf=40m Vtt=80Xtf=l.lRb= lO)

Рисунок 5.6 - Створення моделі транзистора.
- .model KT31SA AKO:KT361A NPN (Bf=108 DEV=20% 1 RE=0.1
- +TRE1=1.5 RB=3 TRB1=1.2 TRC1=1.1RBM=2TRM1=1.3)
- .model KT3102A NPN (Is=5.258f Xti=3 Eg=l.ll Vaf=86 Bf=185 Ne=7.428
- +Ise=28.2ln Ikf=.4922 Xtb=1.5 Var=2 SBr=2.713 Nc=2 Isc=21.2p.
- + Ikr=.2S Rb=52 Rc=1.6S Cjc=9.921p Vjc=.65 Mjc=.33Fc=.5
- + Cje=11.3p Vje=.69 Mje=.ЗЗ Tr=57.71n Tf=611.5p Itf=.52 Vtf=80Xtf=2)
- .model KT3102B NPN (Is=3.628f Xti=3 Eg=l.ll Vaf=72 Bf=303.3 Ne=13.47
- + Ise=43.35n IM-96.35m Xtb=1.5 Var=30 Br=2.201Nc=2Isc=5.5p
- + Ikr=.l Rb=37 Rc=1.12 Cjc=11.02p Vlc=.65 Mjc=.33Fc=.S
- + Cje=13.31p Vje=.69 Mje=.33 Tr=41.67n Tf=493.4p Itf=.12 Vtf=50 Xtf=2)
- .model KT3107A PNP (Is=5.2f Xti=3 Eg=l.ll Vaf=86Bf=140Ne=7.4
- + Ise=28n Ilcf=,49 Xtb=1.5 Var=2S Br=2.7 Nc=2 Isc=21p
- + Ikr=.25 Rb=SO Rc=1.65 Cjc=10p Vjc=.6S Mjc=.33Fc=,5
- + Cje=11.3p Vje=.7 Mje=.33 Tr=58n Tf=62p Itf=.52Vtf=80Xtf=2)
- .model KT3I07B AKO:KT3107A (Bf=25O)
- .model KT312A NPN (Is=21f Xti=3 Eg-1.11 Vat= 126.2 Bf=86.76Ne= 1.328
- + Ise=189f Ikf=.164 Nk=.5 Xtb=1.5 Br=l Nc=l.385 Isc=66.74p Ikr= 1.812
- + Rc=0.897 Rb=300 Cjc=8p Mjc=.29 Vjc=.692 Fc=.S Cje=26.53p Mje=.333
- + Vje=,75 Tr=10nTf=1.743n Itf=l)
авдання для попередньої підготовки.
1. Вивчити відповідний теоретичний матеріал.
2. Опрацювати контрольні запитання.
3. Підготовити звіт.
ід роботи.
1. Запустіть Electronics Workbench.
2. Підготуйте новий файл для роботи. Для цього необхідно виконати наступні операції з меню: File/New і File/Save as. При виконанні операції Save as буде необхідно вказати ім'я файлу і каталог, у якому буде зберігатися схема.
3. Розгляньте схеми на рис. 5.7-5.9. 
Рисунок 5.7 - Схема для визначення вхідної ВАХ (СЕ).
4. Перенесіть необхідні елементи з заданої схеми на робочу область Electronics Workbench. Для цього необхідно вибрати розділ на панелі інструментів (Sources, Basic, Diodes, Transistors, Analog Ics, Mixed Ics, Digital Ics, Logic Gates, Digital, Indicators, Controls, Miscellaneous, Instruments), у якому знаходиться потрібний вам елемент, потім перенести його на робочу область. 
Рисунок 5.8 - Схема для визначення вихідної ВАХ (СЕ).
5. З'єднайте контакти елементів і розташуйте елементи в робочій області для одержання необхідної вам схеми. Для з'єднання двох контактів необхідно клацнути по одному з контактів лівою кнопкою миші і , не відпускаючи клавішу, довести курсор до другого контакту. У разі потреби можна додати додаткові вузли (розгалуження). Натисканням на елементі правою кнопкою миші можна одержати швидкий доступ до найпростіших операцій над положенням елемента, таким як обертання (rotate), розворот (flip), копіювання/вирізання (copy/cut), вставка (paste).

Рисунок 5.9 - Схема для визначення вихідної ВАХ (СБ).
6. Проставте необхідні номінали і властивості кожному елементу. Для цього потрібно двічі виконати подвійне натискування лівою кнопкою миші на зображенні елемента.
7. Коли схема зібрана і готова до запуску, натисніть кнопку включення живлення на панелі інструментів. У випадку серйозної помилки в схемі (замикання елемента живлення накоротко, відсутність нульового потенціалу в схемі) буде видано попередження.
8. Зробіть аналіз схеми, використовуючи інструменти індикації. Вивід термінала здійснюється подвійним натисканням клавіші миші на елементі. У випадку потреби можна скористатися кнопкою Pause.
9. При необхідності зробіть доступні аналізи в розділі меню Analysis.
10. Занесіть пояснення щодо створення схем у звіт.
11. Зробіть висновки.
Контрольні запитання
1. Опишіть принцип дії БТ, приведіть його схеми включення та статичні ВАХ.
2. Які три області (режими) роботи має БТ?
3. Чим визначаються частотні властивості БТ?
Обробка результатів
1. За результатами роботи оформити звіт.
2. Надати результати
Вказівки до звіту
Звіт повинен мати:
· - найменування та мету роботи;
· - відповіді на контрольні питання;
· - виконані завдання;
· - записи досліджень і вимірів;
· - короткі висновки по роботі.
ЛАБОРАТОРНА РОБОТА №3
Тема: Дослідження польових транзисторів.
Мета роботи:вивчення принципу дії та властивостей, дослідження характеристик, ознайомлення з основними параметрами та використанням польових транзисторів.
Матеріальне забезпечення занять
1. Типове робоче місце: персональний , клавіатура, мишка, монітор.
2. Програма ELECTRONICS WORKBENCH.
Короткі теоретичні відомості
Первісна назва польових транзисторів — уніполярні транзистори — було зв'язано з тим, що в таких транзисторах, використовуються основні носії тільки одного типу ( електронів чи дірок). Процеси інжекції і дифузії в таких транзисторах практично відсутні, у всякому разі, вони не грають принципової ролі. Основним способом руху носіїв є дрейф в електричному полі.
Для того щоб керувати струмом у напівпровіднику при постійному електричному полі потрібно змінювати питому провідність напівпровідникового шару чи його площу. На практиці використовуються обидва способи і засновані вони на ефекті поля (керування напругою на затворі). Тому уніполярні транзистори звичайно називають польовими транзисторами. Провідний шар, по якому протікає струм, називають каналом. Звідси ще одна назва такого класу транзисторів – канальні транзистори. Канали можуть бути приповерхневими й об'ємними.
Приповерхневі канали являють собою або збагачені шари, обумовлений наявністю донорних домішок, у діелектрику, або інверсійні шари, що утворюються під дією зовнішнього поля. Об'ємні ж канали являють собою ділянки однорідного напівпровідника, відділені від поверхні збідненим шаром.
Транзистори з об'ємним каналом відрізняються тим, що збіднений шар створюється за допомогою р-п переходу. Тому їх часто називають польовими транзисторами з р—n переходом чи просто польові транзистори. Транзистори такого типу вперше описані Шоклі в 1952 р. У бібліотеці компонентів програми EWB 4.1 вони представлені двома зразками: n-канальним і р-канальним і показані на рис. 4.1 а і б відповідно, де 1 — затвор (gate)- керуючий електрод; 2 - витік (source) — електрод, від якого починають рух основні носії (у першому типі — електрони, у другому — дірки); 3 — стік (drain) -електрод, що приймає ці носії.
Параметри моделей польових транзисторів задаються за допомогою діалогового вікна рис. 4.2 перераховані нижче (у квадратних дужках приведене їхнє позначення в EWB 5.0).

Рис 4.1 Польові n-канальні (а) і р-канальні (б) транзистори з керуючим р-переходом.
- Напруга відсічення, В (Threshold voltage VТО [VTO])— напруга між затвором і витік польового транзистора з р-п переходом чи з ізольованим затвором, що працюють у режимі збіднення, при якому струм стека досягає заданої низької напруги. Для транзисторів з ізольованим затвором, що працюють у режимі збагачення, цей параметр називається граничною напругою
- Коефіцієнт пропорційності, А/В2 (Transconductance coeificient А [КР]).
- параметр модуляції довжини каналу, 1/В (Channel-length modulation lm[LAMB-DA]).
- Об’ємний опір області стоку, Ом (Drain ohmic resistance Rd [RD]).
- Об'ємний опір області витоку, Ом (Source ohmic resistance Rs [RS]).
- Струм насичення p-n переходу, A (Gate-junction saturation current Is [IS])тільки для польових транзисторів p-n переходом.
- Ємність між затвором і стоком при нульовому зсуві, Ф (Zero-bias gate drain junction capacitance Cgd [CGD]).
- Ємність між затвором і витоком, при нульовому зсуві, Ф (Zero-bias gate source junction capacitance Cgs [CGS]).
- Контактна різниця потенціалів p-n переходу, B (Gate junction potential pb[PB])– тільки для польових транзисторів з p-n переходом.
У програмі EWB 5.0 кількість параметрів для польових транзисторів збільшено. Відзначимо, що в EWB для польових транзисторів використовуються моделі PSpise.

Рис 4.2. Вікно встановлення параметрів польових транзисторів з керуючим p-n переходом 
Рис. 4.3 Схема для дослідження ВАХ польового транзистора з керуючим p-n переходом.)
За аналогією з біполярними транзисторами розрізняють три схеми включення польових транзисторів із загальним затвором (З3), із загальним витоком (ЗВ), і з загальним стоком (ЗС).
Для дослідження сімейства вихідних ВАХ польового транзистора в схемі ЗД може бути використана схема на рис.4.3. Вона містить, джерело напруги затвор-витік Ug, досліджуваний транзистор VT, джерело живлення Ucc, вольтметр Ud для контролю напруги стік-джерело й амперметр Id для виміру струму стоку. Вихідна ВАХ знімається при фіксованих значеннях Ug шляхом зміни напруги Ud і виміру струму стоку Id. Напруга Ug, при якій струм Id має близьке до нуля значення, називається напругою відсічення. Маючи характеристики Id=f(Ud), можна визначити крутість S=dId/dUg, що є однією з найважливіших характеристик польового транзистора, як підсилювального приладу.
Інший тип польових транзисторів — транзистори з приповерхневим каналом і структурою метал-діелектрик -напівпровідник (МДН-транзистори). В окремому випадку, якщо діелектриком є оксид (двоокис кремнію), використовується назва МОН-транзистори.
МДН-транзистори бувають двох типів:
- -транзистори з вбудованим каналом;
- -з індукованим каналом (в останньому випадку канал наводиться під дією напруги, прикладеного до керуючого електрода).
У бібліотеці компонентів програми EWB МДН-транзистори з вбудованим каналом представлені двома зразками: n-канальним та р- канальним, попарно показаними на рис. 4.4.а, на якому цифрою 4 позначена підкладка, інші позначення аналогічні позначенням на рис. 4.1. Кожен тип МДН-транзисторів представлені у двох варіантах: з окремим виводом підкладки і, загальним виводом підкладки і витоку. Аналогічний вид мають позначення МДН-транзисторов з індукованим каналом (рис. 4.4).

а)

б)
Рис.4.4 МДН-транзистори з вбудованим (а) і індукованим (б) каналами.
Діалогове вікно установки параметрів МДН-транзисторів показане на рис.4.5 (а-в). У порівнянні з рис. 4.2 у ньому містяться додаткові параметри, призначення яких полягають у наступному (у квадратних дужках —позначення параметрів, прийняті в EWB 5.0).
- Поверхневий потенціал, В (Surface potential ph [PHI]).
- Коефіцієнт впливу потенціалу підкладки на граничну напругу, В1/2 (Bulk-threhold parametr g [GAMMA]).
- Ємність між затвором і підкладкою, Ф (Gate-bulk capacitance Cgb[CGB]).
- Ємність донної частини переходу стік-підкладка при нульовому зсуві, Ф (Zero bias bulk- drain junction capacitance Cbd [CBD]).
- Ємність донної частини переходу джерело-підкладка при нульовому зсуві, Ф (Zero-bias bulk-source junction capacitance Cbs [CBS])
- Напруга інверсії приповерхнього шару підкладки, В (Bulk-junctimli potentisd рв [РВ]).
У програмі EWB 5.0 кількість параметрів моделей МДН-транзисторів збільшено. Вони розміщаються в трьох діалогових вікнах-закладках. До додатково введеного відносяться наступні параметри:
- LD – довжина області бічної дифузії, м;
- RSН — питомий опір дифузійних областей джерела і стоку. Ом;
- JS — щільність струму насичення переходу стік -підкладка, А/м2;
- CJ — питома ємність донної частини р-п- переходу стік -підкладка при нульовому зсуві, Ф/м2;
- CJSW — питома ємність бічної поверхні переходу стік -підкладка, Ф/м;
- МJ-коефіціент плавності переходу підкладка-стік ;
- СGSо-гранична ємність перекриття затвор- (за рахунок бічної дифузії), Ф/м;
CGDO — питома ємність перекриття затвор-стік на довжину каналу (за рахунок бічної дифузії), Ф/м;

Рис. 4.5 (а) - Діалогове вікно установки параметрів МДН-транзисторів.
- CGBO — питома ємність перекриття затвор-підкладка (унаслідок виходу області затвора за межі каналу), Ф/м;

Рис.4.5 б) Діалогове вікно установки параметрів МДН-транзисторів.
- NSUB— рівень легування підкладки, 1/див3;
- NSN– щільність повільних поверхневих станів на границі кремній підзатворний оксид 1/див3;
- TOX – товщина оксиду, м;
- TPG -легування затвора; +1 — домішкою того ж типу, як і для підкладки, -1 домішкою протилежного типу, 0 – металом;

Рис. 4.5 в) Діалогове вікно установки параметрів МДН-транзисторів.
- UO -рухливість носіїв струму в інверсному шарі каналу, див2/У/з;
- FC – коефіцієнт нелінійності бар'єрної ємності прямо зміщеного переходу підкладки;
Для дослідження характеристик МДН-транзисторів використовується схема на мал. 4.6 З її допомогою можна одержати сімейство вихідних характеристик МДН-транзисторів при фіксованих значеннях напруги на затворі Ug і підкладці Ub. Маючи такі характеристики можна визначити крутість транзистора S при керуванні з боку затвора, а також крутість при керуванні зі сторони підкладки Sd=dId/dUd ; статичний коефіцієнт підсилювача M=Ud/Ug вихідний диференціальний опір Rd=dUd/dId і інші параметри.

Рис 4.6. Схема для дослідження характеристик МДП-тразисторів.
На рис. 4.7 наведено приклад створення прикладів моделей вітчизняних транзисторів: